半导体制造工艺
- 首页
- 半导体制造工艺
半导体相关制造流程
积水化学的电子材料战略室可以提供很多胶带/膜/微粒子/塑封材料。针对精细排线·高密度设计·3D实装·薄膜化等日益高涨的最先端需求,以粘结着控制·均一微粒子合成·薄膜涂工·精密多层挤出等为核心技术,提供多种成熟的解决方案。
封装基板制造工艺
-

铜核制造
-

BUF叠层
绝缘增层膜
(Build Up Film) -

通孔,粗化,电镀,
薄膜Masking Tape
防焊油墨涂布 -

DAM材涂布
高粘度Inkjet喷墨用油墨
喷胶打印材料 -
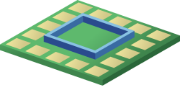
封装完成
晶圆/晶片制造工艺相关产品
我们提供多种有助于提高各种半导体装置(如逻辑半导体、存储器半导体和功率半导体)的性能和制造良率的工艺材料。我们不仅为CMP和封装等“晶圆平坦化”工序中使用的研磨垫设计了适配度高的双面胶带;还提供一款容器,可以将制程中所需各种药品安全清洁地送达Fab各处;以及广泛用于FanOut、2.5D/3D结构等先进封装以及功率半导体等工艺,兼具耐热性、耐药性的UV剥离胶带“SELFA™系列”等。
| 产品 分类 |
产品名 | 特征 | |
|---|---|---|---|
| UV易剥离胶带 | 单面 耐热UV胶带 【SELFA™ HS】 |
结合了耐半导体工艺特性+低残胶的UV剥离胶带。在各种PKG制造过程中可保护器件表面并抑制翘曲。 | 产品情报 |
| UV易剥离胶带 | 双面 耐热UV胶带 【SELFA™ HW】 |
结合了耐半导体工艺特性+低残胶的UV剥离胶带。用于玻璃乘载工艺時,保持高平坦度且兼顧操作使用時的安全。 | 产品情报 |
| UV易剥离胶带 | 单面 耐药性易剥离UV胶带 【SELFA™ MP】 |
具有高耐化学性和低残留性的UV剥離胶帶;透过UV照射产生气体,剥離時可减少對设备的损伤。 | 产品情报 |
| 胶带 | 液晶玻璃基板・CMP・HD基板 【研磨布固定用双面胶带】 |
具有高耐化学性的胶带,剥离后不会有粘合剂残留。用于在电子设备的抛光过程中固定研磨布。宽度2450毫米,适用于CMP工艺应用。 | 产品情报 |
| 容器 | 洁净瓶 | 使用金属离子溶出极少的树脂原料制成的清洁瓶。在粒子管理的洁净环境中制造,为最终产品的品质稳定做出了贡献。在以半导体领域为代表的各种高纯度药液的输送方面已被采用。 | 产品情报 |
封装基板制造工艺相关产品
在先进封装中,基板及其周边材料的技术革新至关重要。我们凭借独有技术,为封装工艺的进化提供先进的材料支持。我们提供具有低损耗,高可靠性的FCBGA用绝缘增层膜(Build-Up Film);有助于提高FCBGA良率和可靠性的液态阻焊膜保护膜;以及能形成数十微米级别3D结构/图案的Inkjet喷墨材料等。
… 环境友善产品
| 产品 分类 |
产品名 | 特征 | |
|---|---|---|---|
| 喷墨材料 | 设备封装周边的图案形成/精密封装用途 【高粘度Inkjet喷墨用油墨】 |
从粘合剂到挡墙材料一应俱全的独家研发的高性能材料。 可自由控制涂布形状。 通过一站式开发优化印刷制程。 | 产品情报 |
| 膜 | 用于制造积层板的层间绝缘膜 【热固化型绝缘增层膜 NX/NQ】 |
传输损耗低,绝缘可靠性高。 | 产品情报 |
| 胶带/膜 | PKG基板製造時 保护表面油墨用的胶带 【薄膜Masking Tape】 |
在洁凈环境下生产的胶带,具有良好的粘附性,光学性能和易剥離性。 | 产品情报 |
封装工艺相关产品
随着半导体器件性能的高性能以及大尺寸化发展,翘曲和热量管理等技术难题也随之而来。为解决相关难题,我们提供通过添加到接合材料中展现间隙控制性能的各种微粒子产品,通过在硅树脂中高密度填充和定向碳纤维,以及使其具有适度弹性和可变形性的高导热垫片等。
… 环境友善产品
| 产品 分类 |
产品名 | 特征 | |
|---|---|---|---|
| 微粒子・填料 | 树脂系微粒子 Micropearl™ | 具有均一粒径分布的塑料粒子。兼具稳定性、柔韧性、反弹性等特性的高功能填料。可用作面内间隔材料、应力缓冲材料、凹凸成型材料等。 | 产品情报 |
| 微粒子・填料 | 金属镀层微粒子 Micropearl™ | 在具有均一粒径分布的塑料粒子表面电镀各种金属后,可作为高性能导电填料使用。依靠独特的制造技术,也可控制硬度。此外,兼具低比重、高分散性、低电阻、高柔韧性等特性,可作为独一无二的高性能轻量填料加以应用。 | 产品情报 |
| UV易剥离胶带 | 单面 耐热UV胶带 【SELFA™ HS】 |
结合了耐半导体工艺特性+低残胶的UV剥离胶带。在各种PKG制造过程中可保护器件表面并抑制翘曲。 | 产品情报 |
| UV易剥离胶带 | 双面 耐热UV胶带 【SELFA™ HW】 |
结合了耐半导体工艺特性+低残胶的UV剥离胶带。用于玻璃乘载工艺時,保持高平坦度且兼顧操作使用時的安全。 | 产品情报 |
| UV易剥离胶带 | 单面 耐药性易剥离UV胶带 【SELFA™ MP】 |
具有高耐化学性和低残留性的UV剥離胶帶;透过UV照射产生气体,剥離時可减少對设备的损伤。 | 产品情报 |
| 散热相关产品 | 超导导热垫片 【MANION™系列】 |
利用磁场排向技术生产的高热传导率碳纤维,同时实现柔软性和密着性的一种散热垫片。 | 产品情报 |
关联词
BG
晶片背面减薄(Back Grinding,BG)是半导体制造后工艺中的一道工序,在前工序中将电路图案形成在晶片表面后,通过从背面薄薄地磨削晶片的过程。BG胶带是这一工序中不可或缺的材料,除了胶带外,还有蜡和粘合剂等。随着近年来半导体工艺的复杂化,对BG胶带的耐热性和耐化学性等提出了更高的要求。
相关页面:UV剥离胶带【SELFA™】
BGA
球栅阵列封装(Ball Grid Array,BGA),是IC晶片封装方式的一种。因为该方法是在基板的背面按阵列方式制作出球形凸起作为引脚,引脚不会超出封装范围,非常适合产品小型化。
BU Film
绝缘增层膜(Build-Up Fill,BU Fill)是在半导体封装阶段,用作连接半导体芯片和主板时所需要的,可满足更精细的布线需求的绝缘性膜材。随着电子设备的布线变得更加精细并且通信变得更快,需要保持较低的传输损耗。另外,随着器件变得更薄,需要材料兼具抑制更薄基板翘曲的功能。
Dam-fill
挡墙填充工艺(Dam-Fill)材料是用于芯片封装或CSP/BGA的外周等位置形成尖锐挡墙的绝缘材料,其目的在与控制芯片粘合时的粘合剂流动性和控制Underfill材料不会使其溢出所需范围。该材料具有优异的成型性,是一种实现降低PKG翘曲的可靠性材料。
相关页面:高粘度Inkjet喷墨用油墨
Dicing
晶圆切割(Dicing)是半导体制造后工序中不可或缺的重要工序。它是将形成了电路的晶圆切割成一个个芯片尺寸并进行分离的工序。切割方法有刀片法、激光法和等离子法等。虽然刀片法常被使用,但为了减少对芯片的机械损伤、应对微小芯片的需求以及考虑到环境问题,有时会选择激光法和等离子法。
相关页面:UV剥离胶带【SELFA™】
Dry Etching
干法刻蚀(dry etching)是通过生成等离子体的离子和反应气体,物理地或通过化学反应除去不需要的部分的干式方法。通常,干法蚀刻常指“反应性离子蚀刻(RIE)”。干法蚀刻能够实现高精度的形状控制,并且无需废液处理,因此广泛应用于制造工艺中。
Fan Out
扇出(Fan Out)是指在比硅芯片更大的面积上布线。使用这种技术的FOWLP(扇出晶圆级封装)不是使用传统的树脂基板,而是在芯片周围的空间通过重新布线层(RDL,Redistribution Layer)配置多个I/O端子,能够在提高布线密度的同时抑制封装的厚度,实现高性能和薄型化。此外,由于其结构,还可以搭载多个硅芯片。
相关页面:UV剥离胶带【SELFA™】
FC-BGA
倒装芯片球栅阵列(Flip Chip-Ball Grid Array,FC-BGA)基板是使用称为凸块的球形端子,将芯片连接到超薄基板上并进行封装的高密度半导体封装基板,可实现LSI芯片的高速化和多功能化。它具有告诉处理信息处理的能力和优异的散热性能,广泛应用于计算机、服务器和网络设备等领域。
Filler
填料(Filler)是为树脂等材料赋予各种功能而添加的填充材料。它指的是微小的颗粒或粉末。通过将具有导热性或导电性等多种功能的填料复合到树脂中,形成填料复合材料,广泛应用于从智能手机到飞机的各种领域。
相关页面:散热相关产品
Flux
助焊剂(Flux)是一种用于半导体制造中焊接工艺的化学品。它用于去除金属表面的氧化物和杂质,并改善焊接的润湿性。随着近年来对精简工艺的需求不断增加,对高性能助焊剂的关注也在上升。
FPC
柔性印刷电路板(Flixible Printed Circuits,FPC)是在聚酰亚胺等基底膜上粘贴铜箔等导电金属并形成电路的基板,通常称为“柔性印刷电路板”。与刚性基板的硬板状不同,它非常薄且重量轻,具有出色的柔韧性,可弯曲,因此可以安装在电子设备内部的弯曲部位、立体布局和狭窄的空间中。随着小型化、轻量化、薄型化的发展,它已被广泛应用于智能手机、液晶电视等各类电子设备中。
GWSS
GWSS(Glass Wafer Support System)是积水化学公司提出的一种临时固定材料(Temporary Bonding De-Bonding material, TBDB material),旨在解决极薄化半导体在搬运时破裂或破损、极薄晶圆的翘曲等问题。积水化学使用独自开发的UV照射自剥离型胶带“SELFA™”来实现了GWSS。为满足最尖端半导体的临时固定需求,积水化学持续研发以提高胶带的耐热性和耐化学性能,
相关页面:UV剥离胶带【SELFA™】
HBM
高带宽内存(High Bandwidth Memory, HBM)高带宽内存是一种由JEDEC标准化的内存规范,基于硅通孔(TSV)技术的裸片堆叠。与用于计算机的传统DRAM(动态随机存取存储器)相比,它能够处理一次大量的数据。它利用比传统DRAM快10到100倍的数据传输速度,应用于GPU(图形处理单元)、HPC(高性能计算)和AI(人工智能)等领域。
相关页面:UV剥离胶带【SELFA™】
Molding
模塑(Molding)是使用热固性树脂等材料,在粘合工序后的芯片上进行包埋,以保护其免受外部冲击、温度变化、湿气等影响的半导体工序。模塑工艺包括将树脂注入并流入模具的传递模塑和将融化的树脂浸入模具成型的压缩模塑。
PoP
PoP(Package on Package)是一种在半导体封装之上堆叠另一个半导体封装的装配方法。通过堆叠半导体封装,可以最大化利用有限的空间,成为实现高功能化和小型薄型化的技术。由于可以将需要数据交换的封装靠近,因此可以进一步提高速度,这项技术在近年来迅速发展,主要应用于移动设备和消费类电子产品中。
TIM
导热界面材料(Thermal Interface Material,TIM)是一种热导材料,能够将电子设备产生的热量高效传递至冷却设备。这使得半导体设备的热管理成为可能,从而维持其性能和可靠性。
相关页面:散热相关产品
TSV
TSV(硅通孔)是指在硅中介层或半导体芯片中形成的贯穿电极,填充铜后成为电极。通过具有TSV结构,可以堆叠芯片,实现通过最小化安装面积和布线的小型化、高性能化和省电化。
相关页面:UV剥离胶带【SELFA™】
Underfill
底部填充树脂(Underfill)是用于封装集成电路的液态热固性树脂。它是一种粘合剂,用于保护电子基板和电子元件的连接部分,如焊接点不受冲击和热量影响。要求具有耐冲击性和返工性等性能。
相关页面:高粘度Inkjet喷墨用油墨
Wafer
晶圆(Wafer)是制造半导体器件的材料。它是通过高度控制成分的单晶硅材料制成的圆柱形锭子,并切割成薄片的圆盘形板。

